

 |
 |
|
Главная страница Транзисторные схемы ряется пропорционально VUc - как в обычном р-п переходе, а горловина канала, сохраняющая потенциал t/ , соответственно сдвигается в сторону от стока. Вследствие этого происходит некоторое укорочение канала (рис. 5-27, б). Аналогичное явление отмечалось при анализе унитронов (см. рис. 5-15). Семейство выходных характеристик Л5ДП транзистора показано на рис. 5-28, а. С увеличением напряжения на стоке (при постоянном потенциале ток 1 сначала нарастает почти линейно (пока дырочный канал вблизи стока слабо деформирован), затем нарастание тока замедляется (поскольку канал вблизи стока су-   Рис. 5-28. Статические выходные (а) и передаточные (б) характеристики МДП транзистора. жается и его сопротивление растет) и, наконец, получается участок насыщения, где ток остается почти постоянным (небольшой рост тока обусловлен уменьшением длины канала, см. выше). Если увеличить напряжение U, то канал обогатится дырками, его исходное сопротивление уменьшится и соответствующая кривая 4 (с) пройдет выше. Насыщение тока в этом случае наступит позднее, так как исходный удельный заряд дырок стал больше и, чтобы свести его к нулю, требуется большее напряжение 11 . В целом семейство выходных вольт-амперных характеристик МДП транзистора напоминает семейство выходных характеристик унитрона (см. рис. 5-16, а). Главное отличие состоит в том, что с ростом параметра L/g у МДП транзистора тОк увеличивается (режим обогащения), а у унитронов уменьшается (режим обеднения). Кроме ТОГО, на семействе МДП транзистора отсутствует кривая с параметром f/g = О, поскольку канал индуцируется только при условии > Uo- При значениях t/g < L/o в цепи стока протекает очень небольшой остаточный ток - ток обратно смещенного стокового перехода. Что касается передаточных характеристик 1 (L/g), то они у МДП транзистора имеют такой же вид, как у унитрона, но сдвинуты относительно нуля координат на величину порогового напряжения (рис 5-28, б). Общий анализ. Задача анализа - найти зависимость тока /с от напряжений Ug и и. При этом исток считается соединенным с подложкой, которая имеет нулевой потенциал. На рис. 5-29 показано распределение положительных зарядов в канале и обедненном слое МДП транзистора. Поскольку ток обусловлен только подвижными носителями, установим связь между током и зарядом дырок в канале. Учитывая, что ток одинаков в любом сечении, рас- Дизлектрик 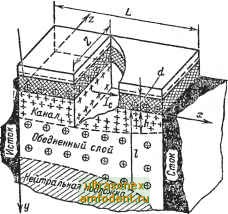 Рис. 5-29. Распредсаение зарядов в структуре МДП транзистора. смотрим произвольное сечение с координатой х. . Считая ток чисто дрейфовым, запишем его плотность в соответствии с (1-72а) в виде h-=q\ypP{x, у)Е, где напряженность Ех принята независимой от координаты у (в пределах крайне малой толщины канала h это допустимо). Поскольку распределение р (у) неизвестно, воспользуемся усредненным значением РсрМ. которое представляет собой интеграл функции р {х, у) по у (в пределах от О до h), поделенный на h. Замена р {х, у) на рр W Дэет усредненную (по оси у) плотность тока. Умножив ее на площадь Zh, получим выражение для тока в следующем виде: /е = iipZQop (х) Ex. (5-46) Здесь Qop (х) = фРср {х) по размерности и физическому смыслу есть удельный заряд дырок, приходящийся на единицу площади в плоскости XZ (или, образно говоря, расположенный под этой площадью). Дальнейшая задача состоит в определении заряда Qop. Рассмотрим баланс удельных зарядов в МДП транзисторе (рис. 5-30) *. В равновесном состоянии (Us = 0) вблизи поверхности имеется обогащенный слой (см. начало предыдущего раздела). Отрицательный заряд обогащенного слоя балансируется положительными зарядами на затворе и на границе Si - SiOg (рис. 5-30, а). Первый обусловлен контактной разностью потенциалов, а второй - ионами в диэлектрике и поверхностными состояниями донорного типа. Если подать на затвор отрицательное напряжение U- 4>mS заряд на затворе сделается равным нулю, а в обогащенном слое исчезнет ( оттолкнется ) составляющая, связанная с контактной разностью потенциалов (рис. 5-30, б). * Там, где это не вызывает недоразумений, опускаем для краткости слово удельный . Если увеличить напряжение (по модулю) до значения Up (напряжение спрямления зон, см. с. 70), то обогащенный слой полностью ликвидируется, а заряд на затворе становится отрицательным, равным сумме зарядов ионов и поверхностных состояний (рис. 5-30, е). Дальнейшее увеличение t/g сопровождается образованием обедненного слоя, увеличением положительного заряда доноров и соответствующим увеличением отрицательного заряда на затворе; при этом поверхностный потенциал делается положительным и возрастает до значения я 2<Р/7, когда образуется канал. В момент образования канала напряжение на затворе равно пороговому напряжению Uo (рис. 5-30, г). При значениях t/g > >- Uo заряд в дырочном канале растет вместе с напряжением и ; соответственно растет отрицательный заряд на затворе. Поскольку при наличии канала потенциал ф меняется мало (см. предыдущий раздел, с. 296), то заряд обедненного слоя, а вместе с ним и соответствующая составляющая заряда на затворе тоже остаются практически неизменными (рис. 5-30, д). Итак, ИЗ проведенного рассмотрения следует, что удельный заряд дырок в канале можно найти из соотношения Соз = Сор + Сод + Соп.с, (5-47) где Qon.c - суммарный заряд поверхностных состояний и ионов (его обычно не разделяют на составляющие и считают заданной величиной, полученной из измерений). Запишем выражения для зарядов Q03 Сод. входящих в (5-47). Обозначая потенциал поверхности полупроводника в точке х через Ux, приходим к выводу, что напряженность поля в диэлектрике будет - Фмб) - Uxl/d*. Тогда согласно теореме Гаусса удельный заряд -затвора при данном значении х запишется следующим образом:  (Qn.c+Qfi+Qp) Рис. 5-30. Баланс зарядов в структуре МДП транзистора при характерных напряжениях на затворе. (Зоз = ЕоЕд£ = (t/з - ФМ5 - Ux). (5-48) где Ед - относительная диэлектрическая проницаемость диэлектрика. * Обозначение Ux вместо (pg для поверхностного потенциала призвано подчеркнуть, что в данном случае речь идет не о квазиравновесном состоянии
|
|
© 2000 - 2025 ULTRASONEX-AMFODENT.RU.
Копирование материалов разрешено исключительно при условии цититирования. |