

 |
 |
|
Главная страница Транзисторные схемы зисторов . По мере роста отрицательного смещения U3 электроны отталкиваются от поверхности. При этом энергетические зоны сначала спрямляются, а затем искривляются вверх, т. е. поверхностный потенциал делается положительным. Однако до тех пор, пока при-noBf рхностная область сохраняет электронный тип проводимости (точнее, пока сток и исток образуют с этой областью выпрямляющие контакты), проводимость рабочей цепи остается крайне малой й протекание заметного тока по-прежнему невозможно. .. Существует некоторое пороговое напряжение = f/o. по превышении которого энергетические зоны искривляются настолько сильно, что вблизи поверхности образуется инверсионный дырочный слой (см. § 2-4). Именно этот слой играет роль индуцированного канала (рис. 5-24, б). Принято считать [100, 101], что пороговое напряжение соответствует поверхностному потенциалу фт = 2if, где ц1г есть расстояние между уровнем Ферми и уровнем электр,о-статического потенциала в глубине полупроводника (на рис. 5-24 в этой области принято ц>е = 0). Дальнейший рост напряжения слабо влияет на величину ф, поскольку изменения последней всего на несколько фг уже вызывают изменения концентрации дырок в десятки раз [см. (1-176), где ф£ следует заменить на ф. Наряду с образованием дырочного канала под затвором образуется также обедненный слой, в котором положительный заряд обусловлен обнаженными ионами доноров (рис. 5-24, б). Образование обедненного слоя вызвано отталкиванием основных носителей подложки - электронов - от поверхности. Инверсионный слой значительно тоньше обедненного. Толщина последнего составляет сотни ангстрем и более, а толщина индуцированного канала - всего 10-20 ангстрем. Рассмотрим динамику образования канала и прохождения тока в нем. Если в начальном состоянии все электроды МДП транзистора находились при нулевом потенциале, а затем на затвор была подана ступенька напряжения (/3 > fVo. то в первый моме.чт поле будет иметь примерно такую конфигурацию, как показано на рис. 5-25, а. Под действием этого поля электроны перемещаются в сторону от поверхности обнажая ионы доноров и образуя обедненный слой, а дырки движутся к поверхности, накапливаются вблизи границы с диэлектриком и образуют канал . Равновесие наступает тогда, когда поле, обусловленное дыр- В МОП транзисторах с и-каналом наличие равновесного обогащенного электронами слоя равносильно наличию встроенного канала. Для того чтобы получить прибор с индуцированным и-каналом, нужно использовать подложку из весьма низкоомного р-кремния, в котором концентрация дырок превышает концентрацию электронов в приповерхностном обогащенном слое. Однако низкоомный материал ухудшает параметры транзистора (растут емкости, падает пробивное напряжение). Из рис. 5-25, а следует, что дырки поступают в канал не только из подложки, но также из полуметаллических р+-слоев истока и стока. Именно эти слои и являются главными поставщиками дырок, поскольку напряженность тянущего поля вблизи них максимальна, а концентрация дырок в них практически неограниченна, тогда как в подложке и-типа дырок мало и они генерируются сравнительно медленно (с постоянной времени т). ками и ионами доноров, компенсирует исходное поле в подложке, а также на границах истока и стока. Можно считать, что описанный переходный процесс соогветствует заряду емкости затвора. В установившемся состоянии основная часть подложки нейтральна, а поле ограничено узким участком под затвором: силовые линии начинаются на дырках и ионах доноров (а также на ионах в диэлектрике) 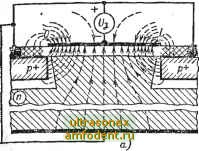 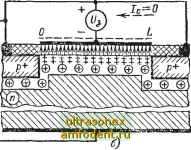 Рис. 5-25. Распределение поля в ЛЩП транзисторе в отсутствие напряжения на стоке. а - в первый момент; 6 - в установившемся состоянии. И кончаются на электроде затвора (на рис. 5-25, б для простоты все силовые линии показаны начинающимися на границе полупроводник - диэлектрик). Поле в диэлектрике однородное, поскольку потенциал всей поверхности полупроводника одинаков и авен (pj ~4>хт- Если теперь, после образования канала, подать ступенчатое напряжение отрицательной полярности между стоком и истоком (считая, что последний по-  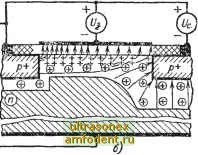 Рис. 5-26. Распределение поля в МДП транзисторе при подаче напряжения на сток. о - в первый момент (показаны линии поля, обусловленные только напряжением Uy, б - в установившемся состоянии. прежнему соединен с подложкой), то в первый момент появляется дополнительное поле, конфигурация которого показана на рис. 5-26, а. Свободные носители начнут двигаться в этом поле, дырки - в сторону стока, электроны - в противоположном направлении. Перемещение электронов в подложке сопровождается обнажением дополнительных ионов доноров (т. е. расширением объемного заряда вокруг стока) и соответствующим нарастанием противополя , обусловленного этими ионами. Данный процесс (процесс заряда барьерной емкости стока) закончится тогда, когда результирующее поле в подложке снова сделается равным нулю, а силовые линии стока будут замыкаться уже не на электрод подложки, а на слой дополнительного заряда донорных ионов (на рис. 5-26, а этот слой показан точками, см. также рис. 5-26, б). Что касается дырок, то их отсос из канала приводит к изменению удельного заряда поверхности (имеется в виду заряд на единицу площади затвора). Согласно теореме Гаусса удельный заряд поверхности однозначно связан с напряженностью поля в диэлектрике: Q, = Zffiji. Следовательно, поле в диэлектрике становится неоднородным: его напряженность убывает от истока к стоку. Такой вывод вполне естествен и основан на том простом факте, что потенциал поверхности под затвором меняется от (рт (на границе истока) до Vc -Ь 4>sm (на границе стока). Если сложить поля, показанные на рис. 5-26, а и 5-25, б то результирующее поле в установившемся состоянии (по окончании заряда барьерной емкости 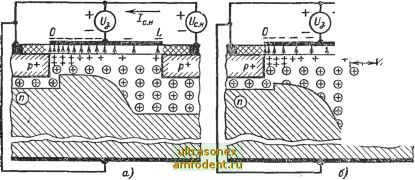 viz,® © ® © © ф @ ф ф © © ф © @ @ Рис. 5-27. Распределение поля в диэлектрике МДП транзистора. а - на границе насыщения; 6 - в режиме насыщения. стока) будет иметь примерно такую конфигурапиго, как показано на рис. 5-26, б. Как видим, поле в диэлектрике действительно неоднородное, а в самом канале появилась тангенциальная составляющая поля, которая обеспечивает движение дырок (ток), а также их пополнение из р+-слоя истока . При некотором критическом потенциале стока, который называется напряжением насьацения поле в диэлектрике и удельный заряд в полупроводнике вблизи стока делаются равными нулю (рис. 5-27, а). Это значит, что на границе стока образуется горловина дырочного канала или, иными словами, в этом месте обедненный слой доноров выходит на поверхность . При значениях > обедненный слой на поверхности расши- Заметим, что силовые линии между истоком и стоком отсутствуют и, следовательно, движение дырок происходит не под действием поля исток - сток, а под действием поля исток - затвор. Иначе говоря, дырочный канал нельзя уподобить проводящей пластинке, расположенной между истоком и стоком. Роль потенциала состоит в том, что он, во-первых, увеличивает напряженность поля в обедненном слое, окружающем сток (это вызывает отсос дырок, расположенных в этом слое близ поверхности, и тем самым инициирует движение дырок), а во-вторых, придает полю между истоком и затвором такую конфигурацию, при которой имеется тангенциальная составляющая, необходимая для движения дырок (в частности, для их вытягивания из истока).
|
|
© 2000 - 2025 ULTRASONEX-AMFODENT.RU.
Копирование материалов разрешено исключительно при условии цититирования. |