

 |
 |
|
Главная страница Транзисторные схемы r--- Строго говоря, канал транзистора и переход затвора нужно было бы представить в виде линий RC с распределенными параметрами, но это, как всегда, затрудняет последующее использование схемы для расчетов. Поэтому на рис. 5-22 и канал, и затвор представлены сосредоточенными параметрами. Канал представлен дифференциальным сопротивлением и межэлектродной емкостью Q, которая определяется геометрией и материалом прибора. Затвор представлен сопротивлением и емкостью С. Сопротивлением часто пренебрегают в связи с его большой величиной; поэтому на рис. 5-22 оно показано пунктиром. Емкость затвора заряжается через усредненное сопротивление R, которое обусловливает конечную постоянную времени Тд. Усилительные свойства транзистора отражены генератором тока SUg. Сопротивления истока и стока (7? и Rt) показаны условно, так как их влияние (см. выше с. 291) автоматически учитывается при измерении параметров S, Тз и со стороны внешних зажимов. Типичными значениями параметров кремниевых унитронов (в режиме t/си = 10 В, = 0) являются: S = = 0,3--3 мА/В, Гз = 1010 Ом, = = 0,1 1 МОм, = 75 200 Ом, Сз = 3 н- 10 пФ, Сз = 0,5 пФ, Ссз = 0,5 пФ, С, = 0,3 -ь 1 пФ. Фактор шума минимален при сопротивлении источника сигнала /?г = 5 -f- 10 МОм и может составлять < 1 дБ на частоте 100 Гц и менее. Инерционность транзистора отражается не только наличием емкостей, но и тем, что крутизна S является комплексной или операторной величиной, которую приближенно можно выразить следующим образом: эЧл I R. I Рис. 5-22. Эквивале.чтная схема униполярною полевого транзистора для переменных составляющих токов и напряжений. (5-45) где Ts Типичными значениями и граничной частоты /5 являются соответственно 0,5-2 не и 100-300 МГц. 5-5. ПОЛЕВЫЕ ТРАНЗИСТОРЫ С ИЗОЛИРОВАННЫМ ЗАТВОРОМ Структура и классификация. Спецификой унитронов является максимальная проводимость канала при нулевом смещении на затворе. С ростом смещения (по модулю) проводимость канала уменьшается вплоть до полной отсечки. Смещение может иметь только одну полярность, соответствующую отсутствию инжекции через переход. У полевых транзисторов с изолированным затвором последний представляет собой металлический слой, изолированный от полупроводника тонкой диэлектрической пленкой. Наличие диэлектрика снимает ограничение на полярность смещения: она может бьпь как положительной, так и отрицательной, причем в обоих случаях ток затвора отсутствует. Структура таких транзисторов (металл - диэлектрик - полупроводник), как уже отмечалось, лежит в основе их названия: МДП транзисторы. В том весьма распространенном случае, когда диэлектриком является окисел (двуокись кремния), их называют МОП тран- р+ р-канал п -Si (поЗлои<ка) р+ р+ р+ п-Ы (подложка) Рис. 5-23. Структуры МДП транзисторов с собственным (а) и индуцированным (б) каналами. зисторами (по-английски MOS). Две основные структуры МДП транзисторов показаны на рис. 5-23. Первая из них (рис. 5-23, а) характерна наличием специально осуществленного {собственного или встроенного) канала, проводимость которого модулируется смещением на затворе. В случае канала р-типа положительный потенциал 1/ отталкивает дырки из канала (режим обеднения), а отрицательный - притягивает их (режим обогащения). Соответственно проводимость канала либо уменьшается, либо увеличивается по сравнению с ее значением при нулевом смещении. Вторая структура (рис. 5-23, б) характерна отсутствием структурно выраженного канала. Поэтому при нулевом смещении на затворе проводимость между истоком и стоком практически отсутствует: исток и сток образуют с подложкой встречно-включенные р-п переходы. Тем более не может быть существенной проводимости между истоком и стоком при положительной полярности смещения, когда к поверхности полупроводника притягиваются дополнительные электроны. Однако при достаточно большом отрицательном смещении, когда приповерхностный слой сильно обогащается притянутыми дырками, между истоком и стоком образуется индуцированный (наведенный полем) канал, по которому может протекать ток. Значит, транзисторы с индуцированным каналом работают только в режиме обогащения. В настоящее время этот тип транзисторов имеет наибольшее распространение. Физические процессы. У каждой разновидности МДП транзисторов имеются свои, иногда существенные особенности, в зависимости от типа канала (встроенный или индуцированный), типа проводимости канала (р или п), а также от типа диэлектрика, полу-  проводника и металла. Мы подробно проанализируем работу кремниевого МОП транзистора с индуцированным р-каналом, а относительно других разновидностей ограничимся краткими замечаниями. МОП транзисторы с р-каналом характерны отрицательными полярностями рабочих напряжений, поэтому ниже напряжения и потенциалы записываются в виде модулей, чтобы избежать неоднократного употребления знака минус. Прежде всего отметим, что в равновесном состоянии, т. е. в отсутствие приложенных напряжений, приповерхностный слой окисленного кремния (как п-, так и р-типа) всегда обогащен электронами. Соответственно зоны в этом слое искривлены вниз, а на границе с окислом поверхность имеет отрицательный потенциал ф,о (рис. 5-24, а). Причины обогащения приповерхностного слоя электронами следующие: контактная разность потенциалов между металлом затвора и кремнием; поверхностные уровни до-норного типа; положительные ионы в диэлектрике . Первые две причины знакомы по § 2-4. Что касается положительных ионов, то они, как показывает опыт, появляются в процессе окисления кремния и последующей фотолитографической обработки окисла (с. 267). Наиболее распространены ионы натрия и водорода, причем, как правило, они сосредоточены вблизи границы окисла с кремнием. Разумеется, наличие обогащенного электронами слоя затрудняет образование дырочного канала в рассматриваемом типе тран- 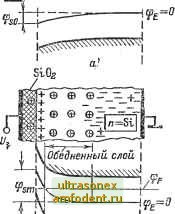 Инверсионный р-слой, (канал) Рис. 5-24. Распределение носителей и зонные диаграммы в МОП транзисторе с индуцированным р-каналом. а - равновесное состояние; б - при отрицательном смещении на затворе. Вообще говоря, контактная разность потенциалов может иметь и положительную полярность; тогда этот фактор противодействует двум другим, т. е. способствует уменьшению отрицательного приповерхностного заряда или даже изменению его знака. Однако для наиболее распрсхтраненной комбинации алюминии - кремний контактная разность потенциалов отрицательна (независимо от типа проводимости кремния, см. табл. 2-1) и, следовательно способствует обогащению приповерхностного слоя электронами.
|
|
© 2000 - 2025 ULTRASONEX-AMFODENT.RU.
Копирование материалов разрешено исключительно при условии цититирования. |