

 |
 |
|
Главная страница Транзисторные схемы этом сопротивление г коллекторного слоя в целом оказывается чрезмерно большим. Выходом из положения является планарно-эпитаксиальная технология, т. е. использование высокоомного эпитаксиального слоя на низкоомной подложке (рис. 4-54, а) или - в технологии интегральных схем - использование скрытого п*-слоя (рис. 4-54, б), получаемого на дне лунки до изготовления основной структуры. В обоих Si02 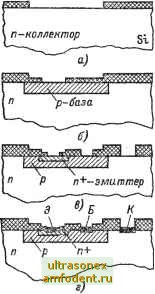 Рис. 4-53. Этапы изготовления планаркого транзистора. а - пластина перед диффузией базы; б - пластина перед диффузией эмиттера; е - пластика перед нанесением контактов; г - результирующая структура транзистора. случаях ТОК протекает в горизонтальном направлении по низкоомному слою, тогда как коллекторный р-п переход расположен в высокоомном слое (т. е. пробивное напряжение достаточно велико). 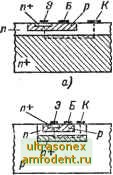 Рис. 4-54. Способы уменьшения Поперечного сопротивления коллекторного слоя. Точками показан путь тока. о - низкоомная подложка с высоко-омным эпитаксиальный слоем; б - скрытый низкоомный ftb-слой. Фотолитография. Процесс фотолитографии [83] неоднократно упоминался как одно из важных средств современной полупроводниковой техники. Сущность фотолитографии применительно к кремниевой планарной технологии состоит в следующем (рис. 4-55). На поверхность двуокиси SiOg наносится равномерный слой фотоэмульсии, так называемого фоторезиста. Сверху на слой фоторезиста накладывается стеклянная маска с прозрачными и зачерненными участками - фотошаблон. Сквозь эту маску засвечивают фоторезист ультрафиолетовым светом, как при обычной контактной фотопечати. После этого пластину с фоторезистом проявляют; в процессе проявления засвеченные участки фоторезиста стравливаются, и Б этих местах обнажается поверхность двуокиси кремния. Оставшийся (незасвеченный) слой фоторезиста подвергают термическому дублению - полимеризации, в результате чего этот ТраВитель Свет  5г0г а) б) в) Рис. 4-55. Основные этапы фотолитографии по кремнию. а - процесс засветки фоторезиста (ФР) через фотошаблон (ФЩ); б - травление оксидной пленки через окно в проявленном и задубленном фоторезисте; в - пластина после удаления фоторе- зиста. слой становится нечувствительным к химическим травителям. Поэтому, когда на следующем этапе пластину подвергают травлению, растворяются лишь обнаженные участки двуокиси кремния, вплоть до поверхности самой пластины, вследствие чего в оксидной маске получается необходимая совокупность окон , через которые в дальнейшем проводят локальную диффузию. Заключительным этапом фотолитографии является удаление задублен-ного слоя фоторезиста, после чего пластина с оксидной маской готова к использованию для проведения диффузии. Изготовление накладных фотошаблонов представляет самостоятельную, достаточно сложную задачу, поскольку размеры окон в настоящее время нередко составляют всего несколько микрон, а следовательно, края этих окон должны выполняться с еще большей точностью. Цикл производства фотошаблонов (рис. 4-56) начинается с Рис. 4-56. Этапы изготовле- - ния фотошаблона под окна вычерчивания оригинала в масштабе омических контактов : 1 и более по отношению к ре- (рис. 4-53, в). Масштабы не альным размерам будуп1его рисунка. выдержаны. Такое вычерчивание (или чаще, выца- о - оригинал; б - промежу- rvom. ТОЧНЫЙ негатив; в - участок РаПЫваНИе на тонком непрозрачном фотошаблона после-мулЬтипли- слое) осуществляется на специальных кации, прецизионных установках - координатографах. Далее следует промежуточный отсъем - (ютографирОБание оригинала с умень-ением размеров в 20-40 раз. Полученный негатив использу- 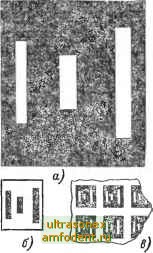 ется для размножения изображений {мультипликации), поскольку групповой метод производства предполагает изготовление множества однотипных структур (диодов или транзисторов) на одной пластине. Мультипликация осуществляется путем шагового перемещения фотопластинки и последовательного экспонирования на нее промежуточного изображения с одновременным уменьшением его размеров до окончательного масштаба. Полученный фотошаблон хранится в качестве эталона; с него переснимаются рабочие копии . Одиночные фотошаблоны являются редким исключением. Обычно для изготовления любого диода или транзистора требуется комплект согласованных шаблонов (из 4-5 шт. и более), каждый из которых используется на соответствующем этапе технологического процесса для создания той или иной конфигурации окон Б оксидной маске. Глава пятая РАЗНОВИДНОСТИ ТРАНЗИСТОРОВ 5-1. ТОЧЕЧНЫЙ ТРАНЗИСТОР Точечные транзисторы были первыми полупроводниковыми трехполюсниками, в которых обнаружился эффект усиления. Открытие усилительного эффекта в полупроводниковом приборе было предопределено интенсивными исследованиями германиевых и кремниевых точечных диодов в 1943-1948 гг., поскольку эти диоды играли важную роль в новой для того времени области науки и техники - радиолокации. В июне 1948 г. Д. Бардин и В. Браттейн, исследуя поверхностные явления Б точечном германиевом диоде, расположили вблизи основного контакта диода еще одну иглу - зонд (рис. 5-1). Оказалось, что если зонд находится под достаточно большим обратным напряжением, то ток в его цепи повторяет изменения тока через основной контакт, а мощность в цепи зонда может превышать мощность Б цепи контакта [84]. Это явление после соответствующих технологических и конструктивных разработок было реализовано в виде точечных транзисторов. Теория последних достаточно сложная; поэтому ограничимся описанием ее основных положений. При формовке контактов точечного транзистора под эмиттерной иглой образуется слой р-типа, а под коллекторной иглой - двойной р-п слой (рис. 5-2). Такая асимметрия контактов обу- * В процессе фотолитографии фотошаблоны изнашиваются, и их время от времени приходится заменять. 2 Далее везде имеются в виду германиевые транзисторы, так как в период развития точечных транзисторов методы очистки кремния и получения в нем р-п переходов еще не были освоены.
|
|
© 2000 - 2025 ULTRASONEX-AMFODENT.RU.
Копирование материалов разрешено исключительно при условии цититирования. |