

 |
 |
|
Главная страница Транзисторные схемы этом неизбежен промежуточный (хотя бы и очень тонкий) слей воздуха или поверхностных пленок. Настоящий переход получается в единой пластинке полупроводника, в которой тем или иным способом (см. § 4-13) получена достаточно резкая граница между слоями р и . Резкость границы играет существенную роль для формирования перехода, так как чересчур плавный переход, как показывает теория, не обладает теми вентильными свойствами, которые лежат в основе работы полупроводниковых диодов и транзисторов 124]. Понятие резкости формулируется следующим образом: граница между слоями является резкой, если градиент концентрации примеси (считающийся постоянным в пределах перехода) удовлетворяет неравенству 1ш>п (2-1) ©  Рис. 2-2. Распр*деление полных и 8ф(};ективных концентраций примеси вблизи металлургической границы плавного перехода. где N - эффективная концентрация примеси (см. стр. 21), а lot - дебаевская длина в соб-сгвенном полупроводнике 1см. (1-87)]. Для кремния и германия необходимо соответственно: dNIdx > 10 см- и dNIdx > 4 lOi см Критерий (2-1) говорит о том, что концентрация примесей в переходе должна существенно изменяться на отрезке, меньшем Такое требование имеет определенный физический смысл. Пусть N = Ла - N есть эффективная концентрация акцепторов, которая линейно спадает в направлении слоя п (рис. 2-2). В точке а; = О, где N = О, имеем компенсированный, т. е. практически собственный полупроводник (см. рис. 1-13, е). Далее, при л: > О, нарастает эффективная концентрация доноров с прежним (по модулю) градиентом. Если градиент dNIdx не удовлетворяет условию (2-1), т. е. очень мал, то существенные (сравнимые с л,-) эффективные концентрации примесей получаются вдали от точки л; = О, на расстояниях, значительно больших глубины экранирования /д.. Тогда поля объемных зарядов, обусловленных ионизированными примесными атомами, тоже будут расположены вдали от металлургической границы и не будут соприкасаться в точке а; = 0. Соответственно в окрестности металлургической границы не сможет образоваться двойной электрический слой, свойственный электронно-дырочному переходу. Переходы, в которых имеется скачкообразное изменение концентрации на границе слоев (dNIdx = оо), будем называть ступенчатыми. Они представлягот собой предельный случай более общего класса плавных переходов, в которых градиент концентрации примесей конечен, но удовлетворяет неравенству (2-1). На практике ступенчатые переходы являются, конечно, известным приближением. Однако они хорошо отражают свойства многих реальных р-п структур и, кротле того, оказываются проще для анализа. Поэтому ниже им будет уделено главное внимание. Контакты, в которых условие (2-1) не соблюдается, ие называют переходами, а относят к неоднородным полупроводникам. По соотношению концентраций основных носителей в слоях pan переходы делятся на симметричные и несимметричные. В симметричных переходах имеет место соотношение Рр Пп, т. е. концентрации основных носителей в обоих слоях почти одинаковы. Такие переходы трудно реализовать практически, и они не являются типичными. Гораздо большее распространение имеют несимметричные переходы, в которых выполняется неравенство Рр>Пп или Пп Рр и концентрации различаются в несколько раз и более. Именно такие переходы будут анализироваться в дальнейшем, причем для определенности будет считаться, что слой р более низкоомный, чем слой п, т. е. Рр > Пп- Полученные выводы легко использовать при обратном соотношении концентраций. В случае резкой асимметрии, когда концентрации основных носителей различаются более чем на порядок, переходы называют односторонними и обычно обозначают символами р*-п (или rf-p). Иногда, чтобы отличить просто несимметричные переходы от односторонних, используют для первых обозначения р*-п (или п*-р), а для вторых р-п (или п-р). В дальнейшем несимметричность (и даже односторонность) переходов будет подразумеваться без использования указанных индексов, за исключением специальных случаев, когда отсутствие индексов может вызвать недоразумения. Структура р-п перехода. Концентрации примесей и свободных носителей в каждом из слоев диода показаны на рис. 2-3, а, приче.\1 для наглядности разница в концентрациях рр и п принята гораздо меньшей, чем это имеется в действительности. Поскольку концентрация дырок в слое р значительно больше, чем в слое п, часть дырок диффундирует из слоя р в слой п. При этом в слое п вблизи границы окажутся избыточные дырки, которые будут рекомбинировать с электронами до тех пор, пока не будет выполнено условие равновесия (1-16). Соответственно в этой области уменьшится концентрация свободных электронов и обнажатся некомпенсированные положительные заряды донорных атомов. Слева от границы обнажатся некомпенсированные отрицательные заряды акцепторных атомов, поскольку часть дырок перешла отсюда в слой п (рис. 2-3, б). Аналогичные рассуждения действительны для электронов слоя п, которые частично диффундируют в слой р. Однако в несимметричном переходе, в котором < рр, диффузия электронов в слой р малосущественна, поскольку разность концентраций п - - Пр несравненно меньше разницы рр - р , а именно этими разно- стями согласно (1-114) определяются градиенты концентраций и диффузионные токи. Область образовавшихся пространственных зарядов и есть область р-п перехода. Часто эту область называют обедненным или истощенным слоем, имея в виду резко пониженную концентрацию подвижных носителей в обеих ее частях. Однако, строго говоря, переход и обедненный слой - не одно н то же: область перехода несколько шире потому что объемные заряды и связанное с ними поле зарождаются уже при очень небольшом р-слой. п-слой р-слой- l-lfll еееее + + + + + е+ееее © ©©©© 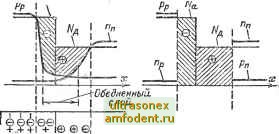 ©ее ©eeiee ©©eje© ©©©*Э ё)©©!©© © © ®1 + © © ©i ©©©1 е Акцептор +Дырка. © Донор - Электрон Переход © @ © ®
Переход Рис. 2-3. Структура р-п перехода. а - начальное состояние слоев; б - пространственные заряды в реальном переходе: в - просгранстиенные заряды в идеализированном переходе. (несколько процентов) уменьшении концентрации носителей по сравнению с равновесной, тогда как понятию обедненного слоя соответствует спад концентрации носителей по крайней мере на порядок (рис. 2-3, б). Промежуточные участки между границами обедненного слоя и перехода являются участка.ми экранирования р- и п-слоев диода от поля создаваемого зарядами обедненного слоя. При перепаде концентраций носителей на три порядка и более протяженность участков экранирования обычно не превышает О 1 мкм, тогда как ширина собственно обедненного слоя, как увидим ниже, Б несколько раз больше. Поэтому есть основания идеализировать переход так, как показано на рис. 2-3, е, т. е. полностью пренебречь наличием свободных носителей в переходе и считать его границы совпадающими с границами обедненного слоя. Такая идеализация существенно упрощает решение многих задач, за исключением, конечно, тех, которые непосредственно связаны с анализом потоков носителей.
|
|
© 2000 - 2025 ULTRASONEX-AMFODENT.RU.
Копирование материалов разрешено исключительно при условии цититирования. |