

 |
 |
|
Главная страница Транзисторные схемы 100 мА сопротивление эмиттерного перехода ничтожно мало и с ним практически можно не считаться. Поэтому в схеме ОЭ входным сопротивлением будет по существутолько сопротивление базы rg. (см. рис. 4-24) *. Последнее при высоких уровнях инжекции модулируется (см. рис. 2-34) и обычно лежит в пределах до 10 Ом. Малое значение входного сопротивления не является препятствием для применения мощных транзисторов, если связь с источником сигнала осуществляется через трансформатор. Сопротивление коллекторного перехода при токах около 1 А составляет всего несколько кило-ом, а сопротивление Гк в схеме ОЭ - сотни ом. 1,=М - 400 300 -250 100 \ : 1((==50мА 10 20 30 в 10 20 30 в Рис. 4-33. Коллекторные характеристики мощного транзистора. а - в схеме ОБ; б - в схеме ОЗ. Тепловой ток коллектора, пропорциональный площади перехода, доходит у мощных транзисторов до десятков {миллиампер. С приближением напряжения к максимально допустимому значению тепловой ток увеличивается в несколько раз в связи с возрастающей ролью термогенерации и ударной ионизации в переходе, а также саморазогрева. Как известно, при больших эмиттерных токах наблюдается уменьшение коэффициентов передачи аир (см. рис. 4-19, б). У мощных транзисторов эта зависимость весьма существенна: коэффициент Р в рабочем диапазоне токов может уменьшиться в 2-3 раза, а иногда и больше. В связи с этим характеристики коллекторного семейства заметно сближаются в области больших токов, особенно в схеме ОЭ (рис. 4-33). Результатом такой неоднородности харак* * Такие мощные транзисторы, у которых г = О, удобно характеризовать крутизной S в схеме ОЭ. Используя условие = О, получаем; тогда В зависимости от тока крутизна лежит в пределах от 1-2 до 10-20 А/В.  500- теристик являются, конечно, нелинейные искажения при усилении сигналов. Одной из главных проблем при конструировании и эксплуатации мощных транзисторов является обеспечение теплоотвода [60]. Эта проблема решается путем непосредственного контакта коллектора с корпусом транзистора и применением внешних радиаторов. В некоторых случаях радиатором может служить шасси. Если схема усилителя не допускает электрического контакта между коллектором и шасси (т. е. заземления коллектора), можно использовать тонкие слюдяные прокладки, изолирующие корпус транзистора от радиатора или шасси. Такие прокладки сравнительно слабо влияют на тепловой контакт, т.е. не сильно увеличивают тепловое сопротивление системы Тепловое сопротивление убывает с увеличением площади теплоотво-да и потому имеет минимальное значе- 5. ние у наиболее мощных транзисторов. Тепловое сопротивление в отсутствие радиатора не допускает рассеяния мощ- ШО -ности больше 1-4 Вт. Наличие радиатора снижает значение Rf и приближает его к тепловому сопротивлению участка переход-корпус. Соответственно допустимая мощность сильно возрастает. На рис. 4-34 показана типичная кри- О 10 20 зОВт вая, иллюстрирующая роль радиатора, ри. 4.34. Зависимость до- В заключение рассмотрим одно яв- пустимой мощности рассея-ление, которое характерно для мощных ния от площади радиатора, транзисторов, но, вообще говоря, имеет место во всех случаях, когда падение нап)яжения /gra в активной области базы (область 1 на рис.. 4-14) примерно равно срг и более: Это явление, получившее название эффект оттеснения тока [74, 58], состоит в следующем. Поскольку ток базы протекает параллельно плоскостям эмиттера и коллектора, потенциал базы уменьшается от центра эмиттера к его периферийным частям (рис. 4-35, а). Соответственно разность потенциалов Vu будет минимальна в центре и максимальна на краях эмиттера. В значительно большей степени будут разли-.чаться плотности тока, так как они согласно (2-32) экспоненциально зависят от Если падение потенциала вдоль базы превышает 2фг, то плотности тока в центре и на периферии эмиттера различаются на порядок и более, т. е. фактически весь ток эмиттера обусловлен его периферийной частью (на рис. 4-35, а она условно зачернена), а центральная часть почти бездействует . Значит, плотность тока эмиттера, рассчитанная без учета эффекта оттеснения (т. е. исходя из минимального значения LJ в центре эмиттера), будет намного меньше ее реальных значений. Соответственно эффект ттеснения форсирует те явления, которые связаны с высоким уровнем инжекции: все они [в частности, зависимость р (1)] насту-пакуг при заметно меньших токах, чем без учета этого эффекта. Для того чтобы избежать эффекта оттеснения или уменьшить его влияние, следует уменьшать размеры эмиттера настолько, чтобы падение напряжения /gfef под эмиттером было меньше фу.. Можно, например, выполнять эмиттер не в виде диска (рис. 4-3 и 4-14), а в виде кольца, сечение которого соответствует зачерненным участкам на рис. 4-35, а. В случае планарных транзисторов используют мно-гополосковые гребенчатые структуры (рис. 4-35, б), у которых ширина каждой полоски достаточно мала (т. е. Ii < Фт). а суммарная ширина достаточно велика, чтобы обеспечить приемлемую плотность тока.  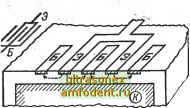 Рис. 4-35. Эффект оттеснения тока в эмиттере. а - разрез дисковой структуры, распределение потенциала базы и плотности эмиттерного тока; б - планарная структура с многополосковыми (гребенчатыми) эмиттером и базой. У маломощных транзисторов эффект оттеснения тока выражен слабо, так как, во-первых, малы размеры эмиттера (от которых зависит сопротивление rgi) и, во-вторых, мал рабочий ток а значит, и ток /б. 4-12. ДРЕЙФОВЫЕ ТРАНЗИСТОРЫ Как отмечалось в § 4-1, в неоднородной базе имеется собственное электрическое поле независимо от уровня инжекции. Поэтому механизм движения инжектированных носителей у транзисторов с неоднородной базой преимущественно дрейфовый, откуда следует их общее название - дрейфовые транзисторы [14, 75]. Поскольку, однако, неоднородность базы достигается путем диффузии примесного материа[ла, можно встретиться с термином транзистор с диффузионной базой , который отражает технологию изготовления, а не механизм движения инжектированных носителей. В последние годы дрейфовые транзисторы стали играть главную роль в связи с развитием микроэлектроники, которой свойственна планарная диффузионная технология (см. § 4-13). Особенности дрейфовых транзисторов. На рис. 4-36 изображены две структуры дрейфового транзистора, различие между которыми обусловлено технологическими особенностями.
|
|
© 2000 - 2026 ULTRASONEX-AMFODENT.RU.
Копирование материалов разрешено исключительно при условии цититирования. |